晶圆研磨,CMP工艺是关键!
晶圆研磨,CMP工艺是关键!

晶圆是半导体的基础,而半导体集成电路的产生是通过在晶圆的薄基板上制造多个相同电路来实现的。
目前集成电路元件绝大多数采用多层立体布线,集成电路制造的前道工艺环节需要进行多层循环,因此需要保证晶圆表面的平坦化。
而刚切割后的晶圆表面有瑕疵且粗糙,会影响电路的精密度,因此需要对其进行进一步的加工,利用CMP工艺,即使用抛光液和CMP设备将晶圆表面研磨至光滑。每一片晶圆在生产过程中都会经历几道甚至几十道的CMP晶圆抛光工艺。
为何CMP是晶圆制程的关键工艺?
CMP全称为Chemical-Mechanical Planarization,直译过来就是“化学机械平坦化”的意思,是集成电路制造工艺过程中实现晶圆表面平坦化的关键技术。

晶圆制造过程主要包括7个相互独立的工艺流程:光刻、刻蚀、薄膜生长、扩散、离子注入、化学机械抛光、金属化。
作为晶圆制造的关键制程工艺之一,化学机械抛光指的是,通过化学腐蚀与机械研磨的协同配合作用,实现晶圆表面多余材料的高效去除与全局纳米级平坦化。
CMP作业原理
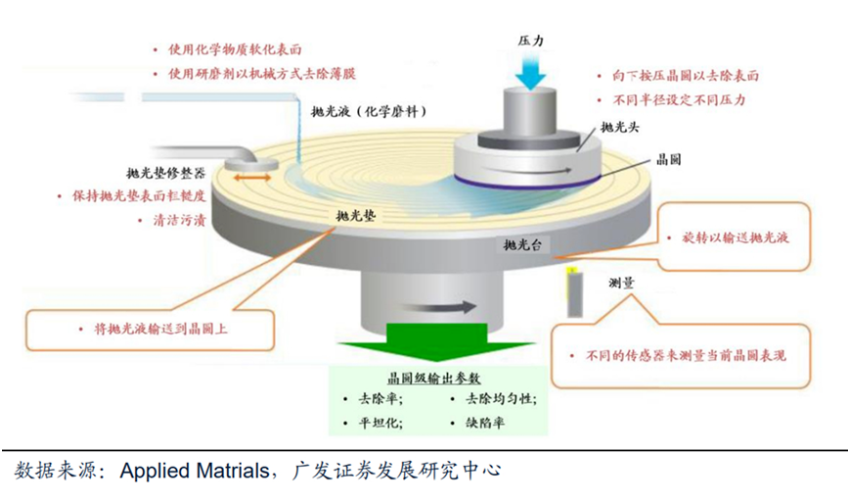
通过CMP设备,利用抛光头将晶圆需要抛光的向下按压在抛光垫上,同时加入抛光液(研磨液),随后抛光盘带动抛光垫旋转,利用抛光液里的微粒与粗糙的抛光垫一同摩擦,从而实现全局平坦化。
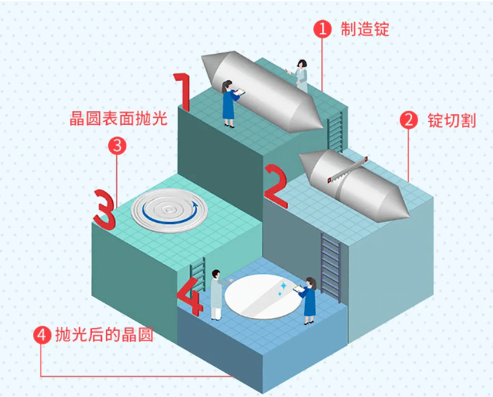
CMP主要耗材
1.抛光液(研磨液)
研磨液的挑选要注意以下几个要素:悬浮液杂质纯度、二氧化硅颗粒尺寸、二氧化硅颗粒硬度及均匀度、研磨液在Lapping作业中是否会析出结晶而影响晶圆品质、表面活性剂的选取及比例、PH值调节、氧化剂选取及比例等等。
如:二氧化硅(SIO2)、氢氧化铵(NH4OH)、有机化合物(ORGANIC COMPOUND)、水(H2O)

2.研磨垫
(1)研磨液要能够在研磨垫上有较好的保持性,才能够保持高效率的抛光效果
(2)研磨垫的表面有适当的硬度,才能保证磨平效果
(3)抛光垫有较好的柔软性,可以随着芯片的弯曲而变形,以保证获得更好的均匀度
(4)研磨后能够将所产生的“副产品”排出,研磨再现性更佳
(5)减少研磨垫材料的杂质,以获得良好的清洁效果

CMP设备
CMP设备能够通过终点检测系统对不同材质和厚度的磨蹭进行实时厚度测量防止过抛,并且能够全局分区施压的抛光头,在限定的空间内对晶圆全局的多个环状区域实现超精密可控单向加压,从而可以响应抛光盘测量的膜厚数据调节压力控制晶圆抛光形貌,使晶圆抛光后表面达到超高平整度。
对CMP设备而言,其产业化关键指标包括工艺一致性、生产效率、可靠性等,CMP 设备的主要检测参数包括研磨速率、研磨均匀性和缺陷量。
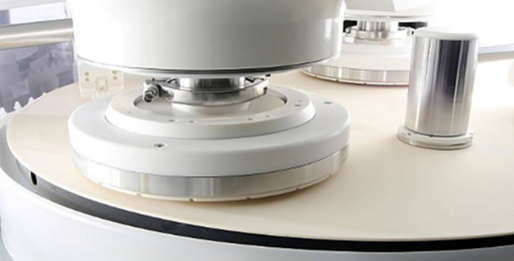
(1)研磨速率:单位时间内晶圆表面材料被研磨的总量。
(2)研磨均匀性:分为片内均匀性和片间均匀性。片内均匀性指某个晶圆研磨速率的标准方差和研磨速率的比值;片间均匀性用于表示不同圆片在同一条件下研磨速率的一致性。
(3)缺陷量:对于CMP而言,主要的缺陷包括表面颗粒、表面刮伤、研磨剂残留, 这些将直接影响产品的成品率。
由于CMP设备的作业原理,为了CMP设备能够正常运行,设备的抛光头、保持环、气膜、清洗刷、钻石碟等关键耗材也会因为长期摩擦而导致快速损耗,因此需要对设备进行定期维保更新。
CMP保持环(CMP Retaining Ring)
由于半导体技术的快速发展,厂家为了能够提升芯片产量,并且降低生产成本,晶圆的直径不断增大;
直径的增大也就导致了加工过程中容易出现翘曲变形,对于150mm直径以上的晶圆还会造成边缘“过磨“的现象,为了不因此导致抛光质量以及晶圆利用率的降低,因此产生了CMP保持环。

CMP保持环能够再CMP设备作业过程中起到固定晶圆的作用,将边缘的抛光垫和晶圆以下的抛光垫按压到同样的高度,有效地解决了边缘“过磨“的问题。

参考资料:
1.《化学机械抛光保持环工艺参数及磨损模型的研究》,西北工业大学,黄杏利
2.《CMP TRIBOLOGICAL STUDY OF CARRIER RING PLASTIC MATERIALS》,W.G.Easter,G. D. Willis,etc
我司抛磨技术经验丰富,对于工件的表面处理有多年的实际操作经验和测试方案、过程等,可根据不同的品质要求定制最优抛光解决方案。如您对上述CMP晶圆研磨想要一步了解,欢迎扫描下方二维码,与我司客服联系。



